應用分享 | 異形器件的失效分析測試方案之原位XPS+AES
失效分析(Failure Analysis)是探究元器件失效根源的重要手段,旨在為元器件設計、工藝、制造等流程提供改進方向,從而提升產品良率和可靠性。在失效分析中,經常遇到異形器件,其不規則的形狀與多元組件構成的特征尤為明顯,直接影響著產品的性能。值得注意的是,特征尺寸在微米/亞微米級別的異形器件的表征往往存在著諸多挑戰。
一方面,受限于傳統分析設備的空間分辨能力,元器件微小特征的微區分析會遇到難以準確定位和準確分析的障礙,直接影響了測試結果的準確性。對此,PHI創新性推出了掃描微聚焦型XPS技術,該技術憑借小束斑X射線的掃描能力,不只實現了小束斑X-ray對微區準確分析,還通過微聚焦的X射線掃描樣品表面激發二次電子成像(Scanning X-Ray induced secondary electron imaging,SXI),直觀呈現類似SEM的樣品表面形貌特征,實現準確導航和定位。此外, PHI XPS—GENESIS作為全新一代的產品,還可選配掃描俄歇(SAM)配件,集成了高空間分辨的SEM成像以及AES元素成像能力,實現了原位XPS+AES的一體化分析,徹底解決了微區表征中導航難、定位難、準直分析難的痛點。
另一方面,異形器件結構特殊、形狀復雜,如凹槽型、L型半導體場效應晶體管,在橫向和縱向上均存在明顯差異。因此,全方面的、有效的分析策略,不只需要解決器件的形貌和組分在二維分布上的難題,還要解決異形件組分在深度分布的難題。原位XPS+AES技術可以有效解決二維分布難題,而微區深度分析則存在一定難度。XPS深度分析,需結合離子濺射技術,將樣品層層剝離,通過“采譜-刻蝕-采譜”的方式獲取組分的深度分布。然而,離子束的刻蝕面積通常較大,一般的XPS設備單次深度分析只能獲取一個位點的深度曲線局限,意味著只能對單一特征區域進行表征,難以滿足同時對于擁有多個、毗鄰的微區特征樣品的深度分析需求。對此,PHI掃描微聚焦型XPS可以在一次刻蝕過程中同時采集FOV內多個微區的XPS譜圖,從而同時生成多條深度曲線。
接下來,讓我們一起見證PHI GENESIS,如何通過原位XPS+AES分析策略,實現對異形半導體器件的失效分析:
樣品信息
樣品:SiO2/Si基底上的缺陷Au電極(完好區域:OK;缺陷區域:NG)
特征:異形件,俯視:存在多個毗鄰的特征區域;剖面:各組件以嵌入式結合,且高低不平
尺寸:特征區域(①和②)的大的尺寸均在50微米以內,如圖1所示
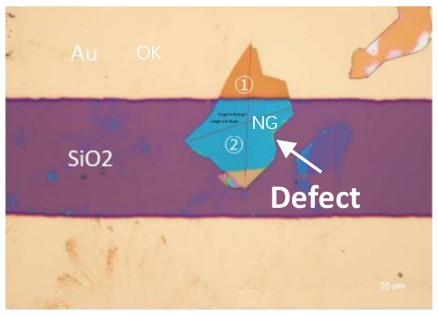
圖1. SiO2/Si基板上的缺陷Au電極光學照片。
失效分析需求
目的:分析器件失效的原因
要求:1. 識別NG區域缺陷/污染物的組分;
2. OK和NG區域形貌和組分的二維分布;
3. 表征該器件的層結構。
面臨的挑戰
挑戰一:NG區域并非只限于表面,實為嵌入式不規則塊體,需進行表面+深度分析。
挑戰二:在橫向,NG存在兩個毗鄰的、尺寸均在數十微米的特征區域,表面微區分析時難以準確定位。
挑戰三:在縱向,該異形件不同區域深度上組分差異明顯,層結構表征中不能只靠傳統的XPS深剖,還需實現深度方向上的微區分析。
分析方案
a. SXI導航和定位:采集樣品表面的SXI影像,通過SXI準確定位OK和NG區域,并建立測試點;
b. 微區XPS:利用小束斑(10 um)采集OK和NG測試區的XPS全譜和精細譜,獲取污染物的組分和化學態,以分析污染物的來源;
c. XPS Mapping:通過SXI定義面分析區域,采集表面的元素XPS Mapping,以獲取污染物在表面的二維分布;
d. AES Mapping:借助高空間分辨的SAM配件,原位采集樣品表面的SEM圖像,以及元素的AES Mapping;
e. 多點同時深度分析:通過SXI定義多個測試點,再利用氬設備進行刻蝕,同時獲取多個測試點各自的深度曲線。
表面分析結果
如圖2所示,SXI展示了樣品表面的微觀形貌,準確定位到尺寸約為50 um的NG區域。進一步地,利用微區XPS采集全譜和精細譜,表明缺陷區域外源物主要為BN。值得注意的是,盡管NG區域緊鄰SiO2/Si基底,但是全譜中并未檢測到Si元素,表明XPS的信號完全聚焦于NG區域,做到了對微區的準確定位和分析。此外, XPS Mapping直觀地展示了表面B、Au和Si元素的二維分布,成功地獲取了污染物的表面具體分布情況。

圖2. XPS微區分析:缺陷區域的SXI準確定位,準確組分分析和元素XPS mapping。
利用XPS儀器的SAM掃描俄歇配件,進一步對該樣品進行原位AES表征,其結果如圖3所示。SEM展現出比SXI更高的空間分辨能力,使得樣品表面的微觀形貌更加清晰明了。在AES mapping視角下,B、Au和Si的分布情況與先前XPS Mapping一致,缺陷內在BN含量較少的區域,存在富C區,二者的分布呈現互補。測試結果充分體現了二者對于微小特征組分的表征能力。
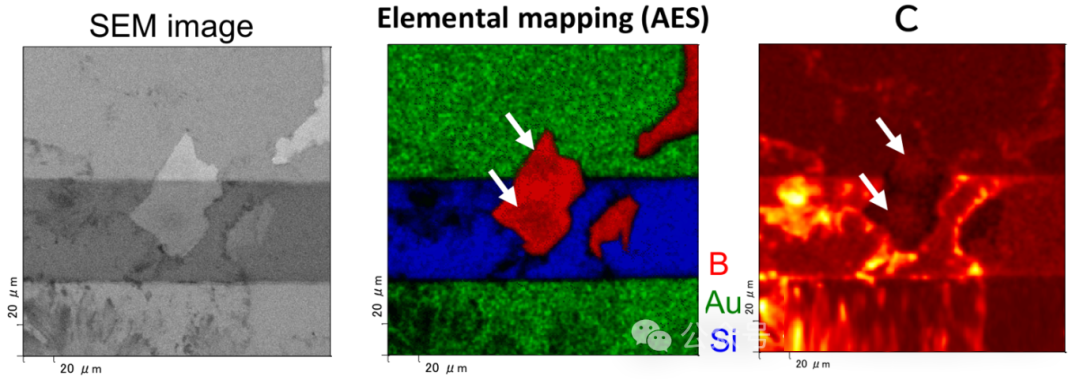
圖3. SAM(掃描俄歇)分析:缺陷區域的SEM圖像和元素AES mapping
深度分析結果
通過SXI分別在缺陷(NG)、Au電極(OK)以及Si基底上定義了3個測試點,結合Ar+進行XPS深度分析。結果如圖4所示,PHI掃描型XPS可在微區內快速往復掃描,同時采集這3個測試點的XPS譜圖,從而同時生成3個深剖曲線,直接展示了該異形件在深度方向上的組分分布情況。由此,成功繪制出該異形樣品的層結構模型。
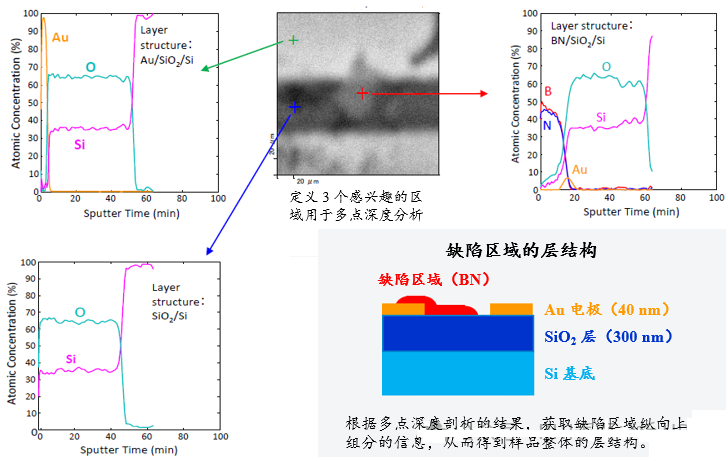
圖4. XPS多點同時深度分析:多方位獲取異形器件的多層結構模型。
PHI XPS以其微區XPS分析能力為基礎,再結合SAM功能配件,鑄就了一款功能強大與完備于一體的表面分析工具。這一組合尤其是在應對微小特征和結構復雜異形器件的失效分析上,可實現對微區特征的準確定位和可靠的分析,展現出無可比擬的優勢和不可替代性。
-轉載于《PHI表面分析 UPN》公眾號
相關產品
全部評論(0條)
推薦閱讀
-
- 異形器件的失效分析測試方案之原位XPS+AES
- 失效分析(Failure Analysis)是探究元器件失效根源的重要手段,旨在為元器件設計、工藝、制造等流程
-

- 應用分享 | HAXPES∣多層結構器件界面的無損深度分析
- XPS的探測深度在10nm以內,然而對于實際的器件,研究對象往往會超過10 nm的信息深度,特別是在一些電氣設備中,有源層總是被掩埋在較厚的電極之下。
-
- 熱點應用丨紅外原位電化學分析在乙二醇燃料電池測試中的應用
- 熱點應用丨紅外原位電化學分析在乙二醇燃料電池測試中的應用
-
- 電鏡應用|掃描電鏡在電纜失效分析中的應用
- Apreo2場發射掃描電鏡具有業內最強的低電壓超高分辨性能,搭配雙引擎模式,分辨率可達到0.8nm(1kV),可以呈現材料最表面的真實形貌襯度。
-
- 日立應用 | 電鏡液體樣品的原位觀察方案
- 日立應用 | 電鏡液體樣品的原位觀察方案
-

- SiC GaN三代半功率器件測試挑戰及應對測試方案
- SiC功率半導體因優勢成行業熱點,但面臨復雜應力挑戰。性能表征測試分靜態和動態,要求高。普賽斯提供一站式高精密測試解決方案,滿足行業高精度、大范圍測試需求,具有模塊化設計,易用且可擴展。
①本文由儀器網入駐的作者或注冊的會員撰寫并發布,觀點僅代表作者本人,不代表儀器網立場。若內容侵犯到您的合法權益,請及時告訴,我們立即通知作者,并馬上刪除。
②凡本網注明"來源:儀器網"的所有作品,版權均屬于儀器網,轉載時須經本網同意,并請注明儀器網(www.shangjinews.cn)。
③本網轉載并注明來源的作品,目的在于傳遞更多信息,并不代表本網贊同其觀點或證實其內容的真實性,不承擔此類作品侵權行為的直接責任及連帶責任。其他媒體、網站或個人從本網轉載時,必須保留本網注明的作品來源,并自負版權等法律責任。
④若本站內容侵犯到您的合法權益,請及時告訴,我們馬上修改或刪除。郵箱:hezou_yiqi
最新話題
最新文章
- 雨量實時監測系統—指導農民合理安排灌溉和排水,優化種植計劃
- 翻斗式雨量監測站—實時測量降雨量,精度可達毫米級
- GNSS形變監測系統—實現多參數聯合監測,提高災害預警的準確性
- GNSS邊坡監測系統—系統提前發出橙色和紅色預警,及時組織撤離,避免了人員傷亡
- 山體滑坡監測預警系統—高精度、實時性和自動化特點,成為地質災害防治的重要技術手段
- 智慧河道水位流量監測系統——以科技之名,打造水位雨量流速流量監測儀
- 水源地水質監測系統——水位雨量流速流量監測儀:守護水域的 “數字衛士”
- 水位在線自動監測監測系統——水位雨量流速流量監測儀:開啟精準監測新篇章
- 智慧河道水位流量監測系統——用監測儀,丈量水位雨量流速流量的 “脈搏”
- 河道水位雨量監測系統——水位雨量流速流量監測儀:水文監測的智慧之眼
作者榜
























參與評論
登錄后參與評論